Основные направления исследований
- Создание эталонов рельефа поверхности твердого тела.
- Исследование влияния микро- и нанорельефа поверхности на физические процессы и явления, происходящие на поверхности твердого тела.
- Разработка методов измерения линейных размеров элементов рельефа в растровых электронных (РЭМ) и атомно-силовых (АСМ) микроскопах.
- Разработка методов калибровки РЭМ и АСМ.
Применение исследований
- Микро- и нанотехнологии.
- Метрология линейных измерений размеров элементов рельефа в нанодиапазоне.
- Калибровка растровых электронных и атомно-силовых микроскопов.
- Системы сканирования и позиционирования микро- и нанодиапазонов.
Создание эталонов рельефа поверхности твердого тела
Для решения проблем, стоящих перед лабораторией, были созданы рельефные поверхности с известной формой и размерами рельефа:
- Одиночные канавки в кремнии с параллельными стенками.
- Шаговые структуры на поверхности кремния в виде набора трапециевидных выступов и канавок.
- Одиночные канавки в кремнии с параллельными стенками.
Расстояние между стенками может составлять от 50 до 500 нм, а глубина - 100 нм - 20 мкм. Отклонение от параллельности по всей глубине не превышает 1 нм. Погрешность измерения ширины канавки составляет 0,3 – 1,0 нм. На рисунке приведено изображение в растровом электронном микроскопе скола одиночной канавки шириной 150,7 нм и глубиной 850 нм.
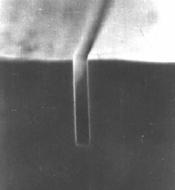
Изображение в растровом электронном микроскопе скола одиночной канавки шириной 150,7 нм и глубиной 850 нм
Шаговые структуры на поверхности кремния в виде набора трапециевидных выступов и канавок представляют собой набор канавок в монокремнии, боковые стенки которых являются кристаллографическими плоскостями {111} кремния, верх выступов и дно канавок между ними – кристаллографическими плоскостями {100} кремния (см. схему на рисунке). Размер шага составляет 2000 нм. Размеры верхних оснований выступов могут быть в диапазоне 10 – 500 нм. Погрешности аттестации размеров элементов шаговых структур (шага структуры, размеров верхних и нижних оснований выступов и канавок и глубины рельефа) составляют 1 нм.

На рисунке приведено изображение в АСМ шаговой структуры на поверхности монокремния, состоящей из трапециевидных выступов, размеры верхних оснований которых составляют 30 нм

Разработанная технология изготовления таких структур позволяет изготавливать их с разными размерами верхних оснований выступов в диапазоне 10 – 500 нм и высот рельефа в диапазоне 100 - 1500 нм.
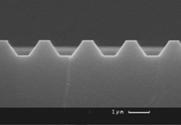 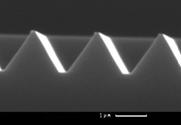 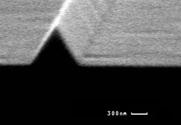
(а) (б) (в)
На рисунке приведены изображения в РЭМ сколов элементов шаговых структур с разными высотами и ширинами выступов.
 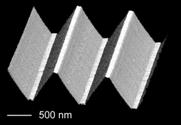 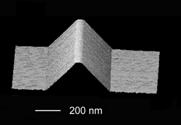
(а) (б) (в)
На рисунке. приведены изображения в АСМ отдельных элементов шаговых структур с разными ширинами и высотами выступов. Размеры верхних оснований выступов на рис.4 и 5 составляют 520, 110 и 30 нм соответственно для рисунков (а), (б) и (в).
Такие структуры являются эталонами рельефа в нанодиапазоне, т.к. границы структур задаются природными параметрами (кристаллографическим плоскостями и углами между ними). Качество созданных структур столь высоко, что эти структуры признаны в качестве государственных стандартов (ГОСТ Р 8.628-2007 и ГОСТ Р 8.629-2007).
Исследование влияния микро- и нанорельефа поверхности на физические процессы и явления, происходящие на поверхности твердого тела
Исследования влияния рельефа поверхности на физические процессы привело к открытию нового механизма вторичной электронной эмиссии, названного “эффектом стряхивания” поверхностных электронов. Этот механизм обладает уникальным свойством – испускание вторичных электронов из поверхностных состояний происходит только при движении первичных электронов из вакуума в твердое тело. При движении первичных электронов из твердого тела в вакуум испускания вторичных электронов из поверхностных состояний не происходит. Вклад этого механизма в полный эффект испускания вторичных электронов может достигать 30 – 70% (для кремния). Особенно сильно влияние эффекта стряхивания на рельефных поверхностях. В этом случае вклад эффекта стряхивания может достигать 100%.
Используя эти исследования были созданы модели формирования изображения рельефных поверхностей в растровом электронном микроскопе, которые позволили разработать методы калибровки РЭМ с помощью прямоугольных и трапециевидных рельефных структур и методы измерения линейных размеров нанометрового диапазона на РЭМ. Оригинальность и высокое качество созданных методов калибровки РЭМ привело к созданию на их основе государственного стандарта (ГОСТ З 8.631-2007).
Исследования взаимодействия зонда атомно-силового микроскопа с рельефной поверхностью и формирования изображения в АСМ позволило разработать методы калибровки АСМ по всем трем координатам и измерения на них линейных размеров рельефных элементов в нанодиапазоне. Оригинальность и высокое качество созданных методов калибровки АСМ привело к созданию на их основе государственного стандарта (ГОСТ Р 8.630-2007).
За создание рельефных поверхностей нанодиапазона с контролируемым рельефом, исследования их свойств, разработку методов калибровки РЭМ и АСМ и разработку методов измерения линейных размеров в нанодиапазоне заведующему лабораторией А.В.Ракову и главному научному сотруднику Ю.А.Новикову присуждена Премия Правительства Российской Федерации 2003 года в области науки и техники.
Наиболее важные достижения лаборатории
- Созданы эталоны рельефа поверхности твердого тела, основанные на природных параметрах твердого тела.
- Обнаружен и исследован новый механизм вторичной электронной эмиссии – эффект стряхивания поверхностных электронов.
- Разработана модель формирования изображения рельефной поверхности твердого тела в растровом электронном микроскопе с учетом эффекта стряхивания.
- Разработаны методы калибровки растровых электронных микроскопов (определение увеличения и размера электронного зонда по двум координатам) для работы в нанодиапазоне.
- Разработаны методы измерения линейных размеров нанодиапазона на растровых электронных микроскопах.
- Разработаны методы калибровки атомно-силовых микроскопов (определение цены деления по всем трем координатам, линейности и ортогональности сканирования и радиуса острия кантилевера) для работы в нанодиапазоне.
- Все созданные структуры и методы доведены до внедрения, в том числе до принятия государственных стандартов.
Публикации
2012-2013
- Кальнов В.А., Новиков Ю.А., Орликовский А.А. Работа электронного литографа в режиме растрового электронного микроскопа. // Микроэлектроника. 2012. Т. 41. № 6. C. 426-429.
- Новиков Ю.А. Виртуальный растровый электронный микроскоп. 1. Цели и задачи виртуальных приборов. // Микроэлектроника. 2013. Т. 42. № 1. C. 34-41.
- Новиков Ю.А. Виртуальный растровый электронный микроскоп. 2. Принципы построения прибора. // Микроэлектроника. 2013. Т. 42. № 4. C. 262-270.
- Новиков Ю.А. Разрешение растрового электронного микроскопа: 1. Современное состояние проблемы. // Поверхность. Рентгеновские, синхротронные и нейтронные исследования. 2013. № 5. С. 105-112.
- Новиков Ю.А. Разрешение растрового электронного микроскопа: 2. Измерение разрешения с помощью структур с прямоугольным профилем рельефа. // Поверхность. Рентгеновские, синхротронные и нейтронные исследования. 2013. № 8. С. 105-112.
- Новиков Ю.А. Измерение нелинейности сканирования в растровом электронном микроскопе. // Поверхность. Рентгеновские, синхротронные и нейтронные исследования. 2013. № 11. С. 70-74.
2011
- Новиков Ю.А. Изображение тест-объекта с трапециевидным профилем и большими углами наклона боковых стенок в РЭМ в обратно рассеянных электронах. // Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2011, № 10, с. 5-11.
2009-2010
- Filippov M.N., Novikov Yu.A., Rakov A.V., Todua P.A. SEM Probe Defocusing Method of Measurement of Linear Sizes of Nanorelief Elements. // International Conference “Micro- and nanoelectronics 2009”, Russia, Proceedings of SPIE, 2010, v. 7521, p. 752116-1 – 752116-9.
- Gavrilenko V.P., Novikov Yu.A., Rakov A.V., Todua P.A. Test objects for calibration of SEMs and AFMs operating at the nanoscale. // International Conference “SPIE Photonics Europe 2010”, Belgium, Proceedings of SPIE, 2010, v. 7718, p. 77180Y-1 – 77180Y-12.
- Gavrilenko V.P., Novikov Yu.A., Rakov A.V., Todua P.A. Accuracy of ellipsometric measurements of Si-SiO2 structures. // International Conference “SPIE Photonics Europe 2010”
- Ларионов Ю.В., Соколов В.О., Плотниченко В.Г. О механизме индуцированного изменения показателя преломления в фосфоро-силикатном стекле. // Квантовая электроника. 2010. Т. 40. № 3. С. 264-268
- Ларионов Ю.В. Роль точечных дефектов в фоточувствительности фосфоро-силикатного стекла, насыщенного водородом. // Квантовая электроника. 2010. Т. 40. № 5. С. 441-448.
- Валиев К.А., Гавриленко В.П., Жихарев Е.Н., Данилова М.А., Кальнов В.А., Ларионов Ю.В., Митюхляев В.Б., Орликовский А.А., Раков А.В., Тодуа П.А., Филиппов М.Н. Измерение линейных размеров кремниевых элементов нанорельефа с профилем, близким к прямоугольному, методом дефокусировки электронного зонда РЭМ. // Микроэлектроника. 2010. Т. 39. № 6. С. 1–7.
2008
В изданиях
- Новиков Ю.А., Раков А.В., Тодуа П.А. Прямое измерение ширины линии на атомно-силовом микроскопе. // Измерительная техника, 2008, № 5, с. 10-12.
- Новиков Ю.А., Раков А.В., Тодуа П.А. Калибровка АСМ по трем координатам с использованием одного аттестованного размера. // Измерительная техника, 2008, № 5, с. 13-15.
- Новиков Ю.А., Раков А.В., Тодуа П.А. Измерение линейности сканирования в атомно-силовом микроскопе. // Измерительная техника, 2008, № 6, с. 12-14.
- Новиков Ю.А., Раков А.В., Тодуа П.А. Точность измерения линейных размеров на растровых электронных микроскопах в микро- и нанотехнологиях. // Измерительная техника, 2008, № 6, с. 15-18.
- Волк Ч.П., Новиков Ю.А., Раков А.В., Тодуа П.А. Калибровка растрового электронного микроскопа по двум координатам с использованием одного аттестованного размера. // Измерительная техника, 2008, № 6, с. 18-20.
- Данилова М.А., Митюхляев В.Б., Новиков Ю.А., Озерин Ю.В., Раков А.В., Тодуа П.А. Тест-объект с шириной линии менее 10 нм для растровой электронной микроскопии. // Измерительная техника, 2008, № 8, с. 20-23.
- Гавриленко В.П., Новиков Ю.А., Раков А.В., Тодуа П.А. Тест-объекты с прямоугольным и трапециевидным профилями рельефа для растровой электронной и атомно-силовой микроскопии. // Наноиндустрия, 2008, № 4, с. 24-30.
- Новиков Ю.А., Раков А.В., Тодуа П.А. Геометрия формирования изображения в сканирующей зондовой микроскопии. // Микроэлектроника, 2008, т. 37, № 6, с. 448-469.
- Гавриленко В.П., Новиков Ю.А., Раков А.В., Тодуа П.А. Метрология и стандартизация в нанотехнологиях. // Заводская лаборатория, Диагностика материалов. 2008, т. 74, Спец. выпуск, с. 31-41.
Доклады на международных конференциях
- Раков А . В ., Новиков Ю . А . International Conference “Instrumentation, Metrology, and Standards for Nanomanufacturing”, San Diego, USA, 2008.( 3 устных доклада) .
- Раков А.В., Новиков Ю.А. NanoScale 2008. 8th Seminar on Quantitative Microscopy and 4th Seminar on Nanoscale Calibration Standards and Methods. Torino, Italy, 2008. (2 стендовых доклада ).
- Gavrilenko V.P., Mityukhlyaev V.B., Novikov Yu.A., Ozerin Yu.V., Rakov A.V., Todua P.A. Test object of the linewidth with a trapezoidal profile and three certified sizes for a SEM and AFM. // NanoScale 2008. 8th Seminar on Quantitative Microscopy and 4th Seminar on Nanoscale Calibration Standards and Methods. Programme and Short Abstracts. Torino, Italy, 2008. p. 51.
- Gavrilenko V.P., Novikov Yu.A., Rakov A.V., Todua P.A. Test objects with right-angled and trapezoidal profiles of the relief elements for SEM and AFM. // NanoScale 2008. 8th Seminar on Quantitative Microscopy and 4th Seminar on Nanoscale Calibration Standards and Methods. Programme and Short Abstracts. Torino, Italy, 2008. p. 59.
Доклады на конференциях в России
- Новиков Ю.А., Раков А.В., Тодуа П.А. 22 Российская конференция по электронной микроскопии, Черноголовка, 2008. (1 устный и 8 стендовых докладов
- Гавриленко В.П., Лесновский Е.Н., Новиков Ю.А., Раков А.В., Тодуа П.А., Филиппов М.Н. Первые российские стандарты в нанотехнологии. // 22 Российская конференция по электронной микроскопии, Черноголовка, ИПТМ РАН, 2008, Тезисы докладов, с. 22.
Митюхляев В.Б., Новиков Ю.А., Озерин Ю.В., Раков А.В., Тодуа П.А. Тест объект ширины линии для РЭМ и АСМ с тремя аттестованными размерами. // 22 Российская конференция по электронной микроскопии, Черноголовка, ИПТМ РАН, 2008, Тезисы докладов, с. 101.
Новиков Ю.А., Раков А.В., Тодуа П.А. Калибровка АСМ по трем координатам с помощью одного аттестованного размера. // 22 Российская конференция по электронной микроскопии, Черноголовка, ИПТМ РАН, 2008, Тезисы докладов, с. 102.
- Новиков Ю.А., Раков А.В., Тодуа П.А. Определение линейности сканирования в атомно-силовом микроскопе. // 22 Российская конференция по электронной микроскопии, Черноголовка, ИПТМ РАН, 2008, Тезисы докладов, с. 103.
- Новиков Ю.А., Раков А.В., Тодуа П.А. Прямое измерение ширины линии на атомно-силовом микроскопе. // 22 Российская конференция по электронной микроскопии, Черноголовка, ИПТМ РАН, 2008, Тезисы докладов, с. 104.
- Новиков Ю.А., Раков А.В., Тодуа П.А. Контроль качества изготовления тест объектов с трапециевидным профилем на РЭМ. // 22 Российская конференция по электронной микроскопии, Черноголовка, ИПТМ РАН, 2008, Тезисы докладов, с. 105.
- Новиков Ю.А., Раков А.В., Тодуа П.А. Тест объекты с прямоугольным и трапециевидным профилями элементов рельефа для РЭМ и АСМ. // 22 Российская конференция по электронной микроскопии, Черноголовка, ИПТМ РАН, 2008, Тезисы докладов, с. 106.
- Митюхляев В.Б., Новиков Ю.А., Раков А.В., Тодуа П.А. Изображение меры МШПС-2.0К в обратно рассеянных электронах. // 22 Российская конференция по электронной микроскопии, Черноголовка, ИПТМ РАН, 2008, Тезисы докладов, с. 139.
- Митюхляев В.Б., Новиков Ю.А., Озерин Ю.В., Раков А.В., Тодуа П.А. Кремниевые тест объекты с размерами рельефных элементов менее 10 нм. // 22 Российская конференция по электронной микроскопии, Черноголовка, ИПТМ РАН, 2008, Тезисы докладов, с. 140.
|

![]()